离子注入设备
SiC用高温离子注入设备 IH-860DSIC
搭载了高温ESC(静电吸附卡盘)的面向SiC量产用的高能粒子注入装置。
产品特性 / Product characteristics
•可实现自动连续高温处理注入
• 1价离子可注入至350keV、2价离子可注入至700keV
(Option:1价离子可注入至430keV、2价离子可注入至860keV)
•通过Dual-End-Station(双工位)实现高产能;
(A系4"高温ESC/B系3"高温ESC、A系6"高温ESC/B系6"常温ESC等等,可配合客户的希望就行规格配置)
•可减轻操作员的负担
• 紧凑式设计
•可大范围对应从试作到量产的各类需求
产品应用 / Product application
• 对应SiC的离子注入装置。
研究开发用中电流离子注入设备IMX-3500
中电流离子注入装置IMX-3500为能量200keV、对应晶圆尺寸8inch的离子注入装置,适用于大学等机构的研究开发。
产品特性 / Product characteristics
• 晶圆尺寸8inch,搭载了可对应不定形基板的台板。
•离子源,除Gas source之外,另外可以使用安全方面更容易处理的B、P、As离子等固体蒸发源。
• HV terminal的部分,与量产装置是同样的构成,可确保高信赖性。
产品应用 / Product application
• 教育、研究开发等
高能对应离子注入设备SOPHI-400
可对应至2400KeV的高能离子注入装置。
产品特性 / Product characteristics
•枚叶式
•可对应薄片Wafer
•平行Beam
产品应用 / Product application
• 功率器件相关薄片基板工艺、IGBT工艺
可对应低速高浓度的离子注入设备SOPHI-30
低加速、高浓度对应的离子注入设备。
产品特性 / Product characteristics
•枚叶式
•可对应薄片
•非质量分离机的对比优点
1)对应低加速.高浓度的好产能离子注入设备
2)相比过去约一半的
3)相比过往设备占用面积为1/3的紧凑型设计
产品应用 / Product application
• Power Device等薄片基板工艺、IGBT工艺
产品参数 / Product parameters
•基板尺寸:Max200mm
日本UlVAC爱发科,公司现已推出可用于使用SiC晶圆的家电和汽车功率元件量产的离子注入设备“IH-860DSIC"。吞吐量为30枚/小时(支持直径为75mm-150mm的晶圆),“现已得到元件厂商的充分肯定,可用于量产"(Ulvac公司)。面向SiC元件量产的离子注入设备“为"(Ulvac公司),希望得到那些计划2006年以后开始SiC元件量产的功率元件厂商的采用。
可在真空腔中连续更换晶圆
面向SiC元件的离子注入设备过去一直在由各设备厂商进行开发,吞吐量较低,每天仅有几枚,不适合量产。吞吐量之所以较低,是因为无法在腔内连续更换晶圆。与硅晶圆相比,SiC晶圆容易因离子注入而产生结晶缺陷,注入离子时需要将晶圆温度维持在500℃的高温,在控制结晶缺陷产生的同时,注入离子。过去一直都是手工将晶圆固定在可调温的晶圆座上,因此更换晶圆时需要在腔内进行放气。
此次通过给设备配备可调温的静电吸盘(Electrostatic Chuck),解决了上述问题。静电吸盘就是利用静电作用力,将晶圆吸附到晶圆座上,能够在真空腔内连续更换晶圆。另外,通过采用可在2个晶圆座上配置SiC晶圆的系统结构,能够一边向一个晶圆进行离子注入,一边同时给另一个晶圆座进行升温作业。由此,将吞吐量提高到了30枚/小时这种适用于量产的水平。
实现了支持SiC的高注入能量
此次的设备除吞吐量之外,还克服了量产所需的另一个条件。作为SiC晶圆,注入离子时在使晶圆保持高温的同时,还需要加大注入能量。其原因在于,在离子注入完成后为消除结晶缺陷而进行退火处理时离子不易扩散,因此注入时需要给底板的表面至深处都注入离子。此次的设备将注入能量由过去的约400keV提高到了700keV,达到了量产所要求的水平。











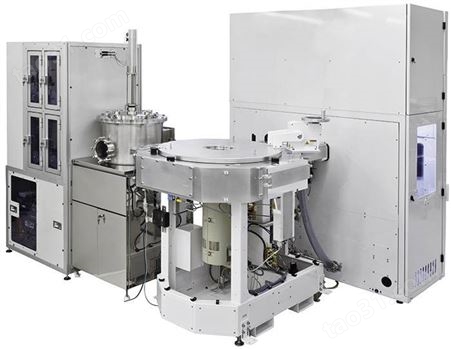


所有评论仅代表网友意见,与本站立场无关。